光刻胶又名“光致抗蚀剂”,是一种在紫外光等光照或辐射下,其溶解度会发生变化的薄膜材料。光刻胶的配方较为复杂,通常由增感剂、溶剂、感光树脂以及多种添加剂成分构成,是集成电路制造的关键基础材料之一,是光刻技术中涉及到最关键的功能性化学材料,广泛用于印刷电路和集成电路的制造以及半导体分立器件的微细加工等过程。光刻胶分为光聚合型、光分解型、光交联型、含硅光刻胶等种类。
另外,光刻胶与芯片息息相关。芯片制造涉及到国民经济、国家安全的方方面面,属于战略性行业。芯片主要通过光刻、刻蚀、封装等工序制作完成。芯片的成功诞生离不开设备、工艺和材料。其中光刻胶作为光刻工艺中的关键材料,直接决定加工的关键尺寸。
为匹配曝光光源和工艺的发展,达到更好的感度和分辨率,光刻胶成膜树脂从聚乙烯醇肉桂酸酯、环化橡胶、酚醛树脂、聚对羟基苯乙烯发展到聚丙烯酸酯、金属氧化物等。
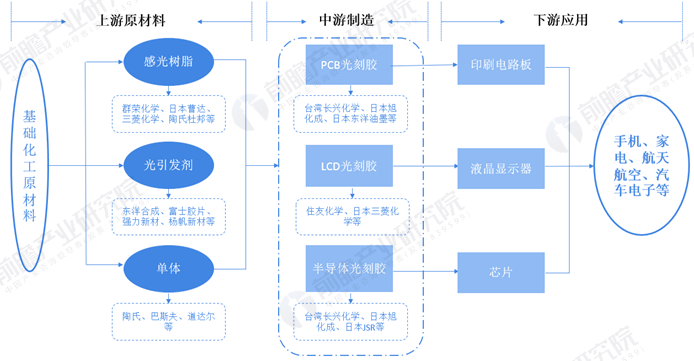
图1、光刻胶的产业链
光刻技术
光刻技术在整个芯片制造中占据重要地位,是实现光刻胶和衬底图案化的关键工序:首先将光刻胶涂覆在衬底上,烘烤除去溶剂,然后通过掩膜版曝光或电子束直写,诱导曝光部分发生化学反应,最后用显影液洗去可溶部分,得到3D光刻胶图形。曝光部分溶解的,光刻胶图形与掩膜版图形一致,称为正性光刻胶;未曝光部分溶解的,光刻胶图形与掩膜版图形相反,称为负性光刻胶。
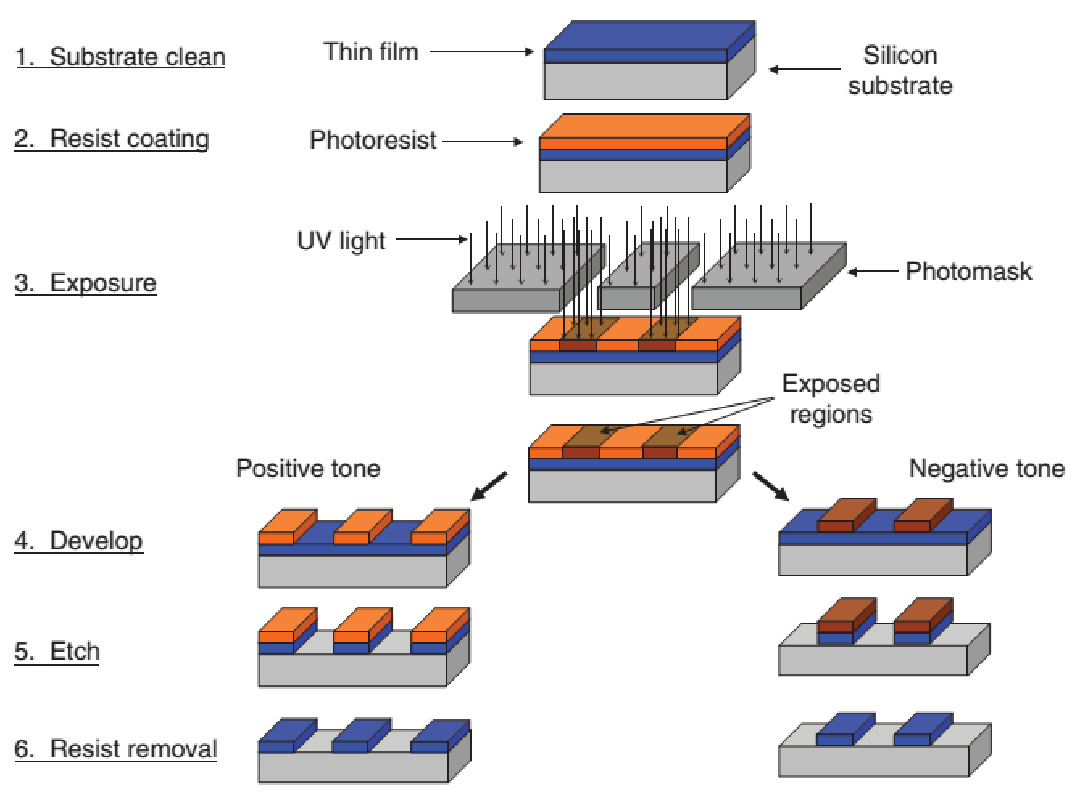
图2、光刻技术的工艺流程
光刻胶的发展
在集成电路技术的发展过程中,有两个定律与之息息相关:一是摩尔定律,由Gordon Moore于1965年提出,即在单位面积制造成本不变的前提下,单个集成电路芯片上晶体管数量每1年翻1番,这一定律在1975年被Moore修正为每2年翻1番,进一步在1995年的回顾中定义为每18个月翻1番;另一个是登纳德定律,是由Robert Dennard于1974年研究发现的,其主旨是晶体管尺寸的缩小使得其所消耗的电压以及电流以类似的比例缩小,即在性能提升的同时功耗降低。摩尔定律从经济学的角度为集成电路的发展提供了方向,登纳德定律则从物理学的角度为集成电路的发展提供了支撑。推动集成电路小型化发展的核心集中在光刻技术上,而光刻技术的发展则可以借助瑞利公式来分析:
R=k1(λ/NA)
R为系统可实现的最小线宽;λ为曝光波长;NA为曝光系统的数值孔径;k1为工艺相关的常数。
由公式R=k1(λ/NA)可以看出,为了得到更小的线宽,可以从3个方面入手:
①降低曝光波长,光刻技术的发展已经历了宽度、G线(436nm)、I线(365)、(248nm)、(193nm)和极紫外光刻(EUV)(13.5nm);
②提高曝光系统的数值孔径,通常I线曝光系统的NA在0.57左右,KrF系统的NA在0.75左右,ArF系统的NA在0.9左右。为了进一步提高系统的NA,光刻工艺引入了浸没式曝光,即在光刻胶与镜头间的空气用水替代。以193nm为例,在水中的折射率为1.44,相当于空气中波长缩小了1.44倍,提高了系统的分辨率。水的引入使得采用更高折射率的透镜成为现实,解决了折射率提高焦深(DoF)损失的问题;
③降低k1,主要是通过优化光刻工艺来实现,主要是分辨率增强技术(RET),如离轴照明(OAI)、相移排膜(PSM)及光学临近效应修正(OPC)等。
上述为提高光刻技术发展的方向,也是光刻胶开发的难点。
下面将分析光刻胶的发展:
除了传统的光刻胶,根据感光波长不同,光刻胶可以分为G线光刻胶、I线光刻胶、248nm光刻胶、193nm光刻胶和EUV光刻胶。
聚乙烯醇肉桂酸酯:最早用作负性光刻胶的光敏高分子化合物,光照时发生环化二聚反应,二个肉桂酸酯间形成四元环交联结构。
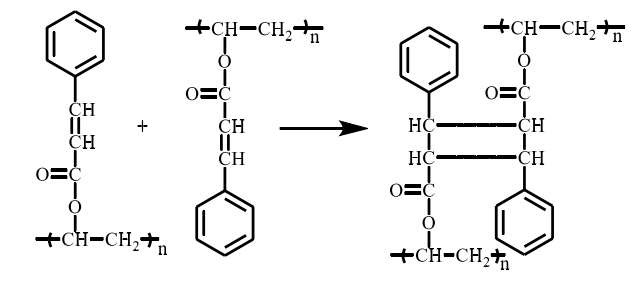
图3、传统型聚乙烯醇肉桂酸光刻胶的交联机理
环化橡胶-双叠氮体系:叠氮化合物在紫外光照射下,放出N2,形成一种叫氮卡宾的物质,它可以以多种形式和双键反应。

图4、环化橡胶-双叠氮体系光刻胶交联机理
酚醛树脂-DNQ体系:酚醛树脂的苯环结构赋予其高耐热、抗蚀刻的特性,适用于光刻胶材料。
酚醛树脂-DNQ体系主要由酚醛树脂、重氮萘醌类光敏化合物和增感剂等组成,该类光刻胶曝光部分的重氮基团发生沃尔夫曼重排,生成羧茚酸,溶解在四甲基氢氧化铵(TMAH)显影液中,起到促溶的作用;未曝光部分的DNQ与酚醛树脂发生偶联反应,起到溶解抑制的作用。

图5、重氮萘醌酚醛树脂光刻胶成像机理
结语
随着光刻技术的发展,光刻胶经历了G/I线光刻胶、248nm光刻胶、193nm光刻胶,进入了EUV光刻胶时代。
所用的材料也由传统的酚醛树脂-重氮萘醌发展为聚对羟基苯乙烯改性树脂与聚甲基丙烯酸酯体系,及最新金属氧化物体系。
光刻技术的发展与光刻材料的不断创新共同推动Moore定律向前延伸,使得芯片的集成度不断提高。
另外,光刻胶的国产替代迫在眉睫,需要整个产业密切合作,以产学研为基础进行技术突破,与集成电路制造企业协同配合推进产品的应用。




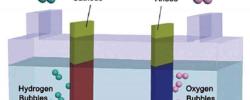




暂无评论
发表评论